CPUチップのパッケージング技術とパッケージング方法:
CPUパッケージング技術は、DIPパッケージング、QFPパッケージング、PFPパッケージング、PGAパッケージング、BGAパッケージングなどに分類されます。
CPUパッケージ形式:OPGAパッケージ、mPGAパッケージ、CPGAパッケージ、FC-PGAパッケージ、FC-PGA2パッケージ、OOIパッケージ、PPGAパッケージ、SECCパッケージ、SECC2パッケージ、SEPパッケージ、PLGAパッケージ、CuPGAパッケージなど。
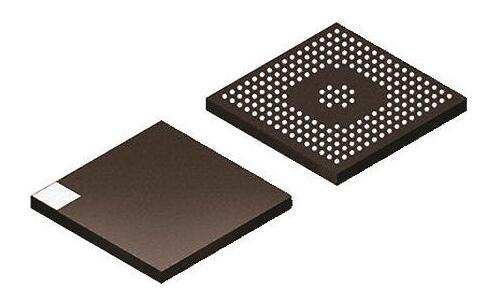
1つは、最初にCPUパッケージングテクノロジーについて説明します。
DIPパッケージ(DualIn-linePackage):
デュアルインラインパッケージング技術とも呼ばれ、デュアルインライン形式でパッケージ化された集積回路チップを指します。ほとんどの中小規模の集積回路はこのパッケージング形式を使用し、ピンの数は通常100を超えません。DIPパッケージのCPUチップには2列のピンがあり、DIP構造のチップソケットに挿入する必要があります。もちろん、同じ数のはんだ穴とはんだ付けのための幾何学的配置を備えた回路基板に直接挿入することもできます。DIPパッケージチップは、ピンの損傷を防ぐために、チップソケットに抜き差しするときに特に注意する必要があります。DIPパッケージ構造の形態は次のとおりです。多層セラミックダブルインラインDIP、単層セラミックダブルインラインDIP、リードフレームDIP(ガラスセラミックシーリングタイプ、プラスチックカプセル化構造タイプ、セラミック低融点ガラスカプセル化タイプを含む)待機します。
DIPパッケージの特徴:
1。PCB(プリント回路基板)へのパーフォレーションはんだ付けに適しており、操作が簡単です。
2.チップ面積とパッケージ面積の比率が大きいため、体積も大きくなります。
4004、8008、8086、8088などの初期のCPUはすべてDIPパッケージを使用しており、それらの2列のピンをマザーボードのスロットに挿入するか、マザーボードにはんだ付けすることができます。
QFPパッケージ:
この技術の中国語の意味は、スクエアフラットパッケージング技術(PlasticQuadFlatPockage)と呼ばれます。この技術によって実現されるCPUチップピンは、ピン間の距離が小さく、ピンは非常に薄いです。一般に、大規模または非常に大規模な集積回路このタイプのパッケージを使用してください。ピンの数は通常100を超えます。
QFPパッケージの機能:
この技術は、CPUをパッケージ化する際の操作と高い信頼性に便利であり、パッケージサイズが小さく、寄生パラメータが低減され、高周波アプリケーションに適しています。この技術は、主にSMT表面実装を備えたPCBへの取り付けと配線に適しています。テクノロジー。
PFPパッケージ:
このテクノロジーの完全な英語名はPlasticFlatPackageであり、中国語の意味はプラスチックフラットコンポーネントパッケージングです。このテクノロジーでパッケージ化されたチップも、SMDテクノロジーを使用してマザーボードにはんだ付けする必要があります。SMDでマウントされたチップは、マザーボードに打ち抜く必要はありません。通常、マザーボードの表面には、対応するピンパッドが設計されています。チップのピンを対応するパッドに合わせて、マザーボードとの溶接を実現します。このようにはんだ付けされたチップは、特別な工具なしでは分解が困難です。この技術は、外観のパッケージ形状が異なることを除いて、基本的に上記のQFP技術と同様です。
PGAパッケージ:
この技術は、ピングリッドアレイパッケージング技術(CeramicPinGridArrauPackage)とも呼ばれます。この技術によってパッケージ化されたチップには、内側と外側に複数の正方行列ピンがあり、各正方行列ピンはチップの周囲に沿って一定の距離に配置されます。ピンは2〜5個の円に形成できます。取り付けるときは、チップを特別なPGAソケットに挿入します。CPUの取り付けと取り外しをより便利にするために、486チップから、PGAパッケージCPUの取り付けと取り外しの要件を満たすために特に使用されるZIFCPUソケットが登場しました。この技術は、一般的にプラグ操作が頻繁に行われる場合に使用されます。
BGAパッケージ:
BGAテクノロジー(BallGridArrayPackage)は、ボールグリッドアレイパッケージングテクノロジーです。このテクノロジーの出現は、CPU、マザーボードのサウスブリッジチップやノースブリッジチップなどの高密度、高性能、マルチピンパッケージに最適な選択肢になりました。ただし、BGAパッケージは基板の比較的広い領域を占めます。この技術のI / Oピンの数は増加しますが、ピン間の距離はQFPの距離よりもはるかに大きいため、アセンブリの歩留まりが向上します。また、この技術では、制御可能な崩壊チップ法を使用して溶接を行うため、電熱性能を向上させることができます。さらに、この技術の組み立ては共面溶接であるため、パッケージの信頼性が大幅に向上します。また、この技術によって実現されるパッケージCPUは、信号伝送遅延が小さく、適応周波数を大幅に向上させることができます。
BGAパッケージの特徴:1。I
/ Oピンの数は増えますが、ピン間の距離はQFPパッケージ方式よりもはるかに大きく、歩留まりが向上します。2。BGAの
消費電力は増加しますが、制御可能な崩壊チップ方式を使用します。電熱性能を向上させることができる溶接。3
。信号伝送遅延が小さく、適応周波数が大幅に向上し
ます。4。アセンブリは同一平面溶接が可能であり、信頼性が大幅に向上します。

次に、現在より一般的なパッケージ形式であるパッケージ形式について説明します。
OPGAパッケージOPGA(OrganicpingridArray、有機ピンアレイ)。
このパッケージの基板は、プリント回路基板の材料と同様にガラス繊維を使用しています。このパッケージング方法は、インピーダンスとパッケージングコストを削減できます。OPGAパッケージは、外部コンデンサとプロセッサコア間の距離を短縮し、コア電源とフィルタ電流の乱雑さを改善します。AMDのAthlonXPシリーズCPUのほとんどは、このタイプのパッケージを使用しています。
mPGAパッケージ
mPGA、ミニチュアPGAパッケージ、現在、AMDのAthlon64やIntelのXeon(Xeon)シリーズCPUなどの少数の製品のみが使用されており、それらのほとんどは優れた製品であり、高度なパッケージ形式です。
CPGAパッケージ
CPGAは一般にセラミックパッケージとも呼ばれ、フルネームはCeramicPGAです。主にThunderbird(Thunderbird)コアと「Palomino」コアAthlonプロセッサで使用されます。
FC-PGAパッケージ
FC-PGAパッケージは、Inverted Chip Pin Grid Arrayの略で、ソケットにピンが挿入されています。これらのチップは、コンピュータチップを構成するダイまたはプロセッサ部分がプロセッサの上部に露出するように反転されています。金型を露出させることにより、熱溶液を金型に直接適用できるため、より効果的な切りくず冷却を実現できます。FC-PGAプロセッサは、電源信号とグランド信号を分離してパッケージの性能を向上させるために、プロセッサ下部のコンデンサ配置領域(プロセッサ中央)にディスクリートコンデンサと抵抗を搭載しています。チップ底部のピンはジグザグに配置されています。さらに、ピンの配置により、プロセッサを一方向でのみソケットに差し込むことができます。FC-PGAパッケージは、PentiumIIIおよびIntelCeleronプロセッサで使用され、どちらも370ピンを使用します。
FC-PGA2パッケージ
FC-PGA2パッケージは、FC-PGAパッケージタイプと非常に似ていますが、これらのプロセッサにヒートシンク(IHS)が統合されている点が異なります。統合されたヒートシンクは、製造時にプロセッサチップに直接取り付けられます。IHSはダイとの熱接触が良好で、表面積が大きく、熱放散が優れているため、熱伝達が大幅に向上します。FC-PGA2パッケージは、PentiumIIIおよびIntelCeleronプロセッサ(370ピン)およびPentium 4プロセッサ(478ピン)に使用されます。
OOIパッケージ
OOIはOLGAの略です。OLGAはSubstrateGridArrayの略です。OLGAチップはまた、プロセッサが基板に下向きに取り付けられ、シグナルインテグリティ、より効果的な熱放散、およびより低い自己インダクタンスを実現する反転チップ設計を使用しています。OOIには、ラジエーターが適切に設置されたファンラジエーターに熱を伝達するのに役立つ統合ヒートスプレッダー(IHS)があります。OOIは、423ピンのPentium4プロセッサで使用されます。
PPGAパッケージ
「PPGA」の完全な英語名は「PlasticPinGridArray」です。これはPlasticPin Grid Arrayの略語です。これらのプロセッサには、ソケットに挿入されるピンがあります。PPGAは、熱伝導率を向上させるために、プロセッサの上部にニッケルメッキされた銅製ヒートシンクを使用しています。チップ底部のピンはジグザグに配置されています。さらに、ピンの配置により、プロセッサを一方向でのみソケットに差し込むことができます。
SECCパッケージ
「SECC」は「SingleEdgeContactCartridge」の略で、シングルエッジコンタクトカードボックスの略です。マザーボードに接続するために、プロセッサはソケットに挿入されます。ピンは使用しませんが、「ゴールデンフィンガー」接点を使用し、プロセッサはこれらの接点を使用して信号を送信します。SECCは、カートリッジアセンブリ全体の上部を覆う金属シェルで覆われています。
カードボックスの背面は、ヒートシンクとして機能する熱材料でコーティングされています。SECCの内部には、ほとんどのプロセッサに、プロセッサ、L2キャッシュ、およびバス終端回路を接続するベースと呼ばれるプリント回路基板があります。SECCパッケージは、242個の接点を持つIntel Pentium IIプロセッサ、および330個の接点を持つPentium IIXeonおよびPentiumIIIXeonプロセッサに使用されます。
SECC2パッケージ
SECC2パッケージはSECCパッケージと似ていますが、SECC2は保護パッケージの使用が少なく、熱伝導性メッキが含まれていない点が異なります。SECC2パッケージは、PentiumIIプロセッサおよびPentiumIIIプロセッサのいくつかの新しいバージョン(242接点)で使用されています。
SEPパッケージ
「SEP」は「SingleEdgeProcessor」の略で、片側プロセッサの略です。「SEP」パッケージは「SECC」または「SECC2」パッケージに似ています。片側のスロットスロットにも挿入され、金の指でスロットに接触しますが、完全にパッケージ化されたシェルはありません。バックプレーン回路は、プロセッサの下部から見ることができます。「SEP」パッケージは、242本のゴールデンフィンガーを備えた初期のIntelCeleronプロセッサで使用されています。
PLGAパッケージ
PLGAは、PlasticLandGridArrayの略語、つまり、プラスチックランドグリッドアレイパッケージです。ピンを使用せず、小さなポイントタイプのインターフェースを使用しているため、PLGAパッケージは以前のFC-PGA2や他のパッケージよりも明らかに小さく、信号伝送損失が少なく、製造コストが低く、処理を効果的に改善できます。信号強度プロセッサの周波数を上げると同時に、プロセッサの歩留まりを上げ、製造コストを削減することができます。現在、Socket775インターフェイスを備えたIntelのCPUはこのパッケージを使用しています。
CuPGAパッケージ
CuPGAは、LiddedCeramicPackageGridArrayの略語です。つまり、カバー付きセラミックグリッドアレイパッケージです。通常のセラミックパッケージとの最大の違いは、トップカバーが追加されていることです。これにより、放熱性能が向上し、CPUコアを損傷から保護できます。現在、AMD64シリーズCPUはこのパッケージを使用しています。

記事は(www.ipcb.jp)から来ています。AudemarsPiguetは、4〜46層のPCBボード、回路基板、回路基板、高周波基板、高-スピードボード、HDIボード、PCB回路基板、高周波高速基板、ICパッケージキャリアボード、半導体テストボード、多層回路基板、hdi回路基板、混合電圧回路基板、高周波回路基板、リジッドフレックスボードなど