概要:
HDI回路基板無電解ニッケル-パラジウム-金(ENEPIG)コーティングは、表面実装、導電性接着剤ボンディング、金線/アルミニウム線ボンディングおよびその他のプロセス要件を同時に満たすことができ、マイクロアセンブリ技術の適用が広く使用されています。マイクロアセンブリプロセスでは、金ワイヤボンディングとはんだ接合の信頼性の観点から化学ニッケル-パラジウム-金PCBのプロセス品質問題が議論され、プロセス信頼性に影響を与えるメカニズムと理由が分析され、プロセス信頼性制御が行われました。提案されました。それに対処する方法。
前書き:
HDI PCB無電解ニッケル-パラジウム-金(ENEPIG)コーティングは、表面実装、導電性接着剤接合、および金線/アルミニウム線接合プロセスを同時に満たすことができます。MiladG、Lin Jinduなどは、無電解ニッケル-パラジウム-金を使用する前のシーンで高い評価を得ています。ニッケルと金の間にパラジウムの薄層を追加して、金が金の浸漬プロセスでニッケルを破壊するのを防ぎ、「黒いパッド」の現象を完全に回避します。このプロセスの金層は非常に薄い(通常は0.1μm未満)。はんだリフローを使用すると、AuSn4の脆い金属間化合物の形成がなく、金の脆化のリスクがありません。厚い金のプロセスラインを電気めっきする必要がなく、プロセスが簡素化され、マイクロ波回路の性能が保証されます。金に比べてパラジウムの価格が安く、パラジウムと金の厚みが非常に薄いため、コスト管理の面で非常に競争力があります。PENGSPらは、EPENIGが鉛フリーはんだSAC305と強固で信頼性の高いはんだ接合を形成でき、めっき層がRoHS要件を満たしていることを議論しました。
化学ニッケル-パラジウム-金プロセスは海外で成熟し、広く使用されています。近年、このプロセスは国内政策で徐々に推進されています。プロセスに関する国内調査は、プロセス分析、アプリケーション調査、品質管理をカバーし、レイヤーごとに実施されます。プロセス制御の複雑さのために、コーティングパラメータ制御システムが不適切であるか、組み立てプロセスパラメータが不確実である場合、それは生産の品質と信頼性に簡単に影響し、主に金線の結合性とBGA部品の溶接を示します信頼できる。性的な問題。
1.ニッケル-パラジウム-金PCBの金線結合性
PCBの無電解ニッケル-パラジウム-金プロセスは、無電解ニッケル-金(ENIG)めっき層の半分にパラジウムの層を追加することです。特定の厚さと外観で満足される無電解ニッケル-パラジウム-金めっき層満足のいくはんだ付け性能と金線接合性能を持ち、非常に高い信頼性を備えています。ただし、PCBメーカーが異なれば、プロセス制御、アセンブリプロセスフロー、および材料も異なるため、金ワイヤボンディングのパフォーマンスに異なる影響を及ぼします。
1.1コーティングの厚さの影響
異なるPCBメーカーは、異なるメッキソリューションの子を使用します。スロットルレベルは同じではありません。3つのメーカーの表1 A、B、Cのように、PCBボードのメッキコーティングの厚さの違いは大きく、NiPdAuPCBボードのメッキ層は通常です。価値と結合張力。
表1工場A、B、およびCのニッケル-パラジウム-金PCBコーティングのパラメーター
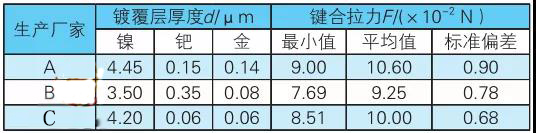
上記のHDI回路基板のめっき層の厚さは大きく異なりますが、外観が平坦で、外色が金色で、平均して光沢に差がない限り、手作業によるボンディングとセミの要件を満たすことができます。 -自動金ワイヤーボンディング。
無電解パラジウム層は、ニッケルと金の間に挟まれた微細で正確な構造を持っているため、ニッケルが金に伸びるのを効果的に防ぐことができます。パラジウム層の品質と厚さは、金のワイヤボンディングプロセスの信頼性にとって重要です。厚さは薄すぎるのには適していません。データは、ENEPIG金ワイヤボンディングと信頼性の試行後、パラジウム層が完成し、パラジウム層の厚さが0.10μm以上であることを示しています。金層自体は、金の浸漬プロセス中に金がニッケル層を破壊するのを防ぐために細心の注意を払って正確なパラジウム層が最善を尽くすため、満足のいく金ワイヤボンディングの経験があります。金層は高純度で、より薄い金層(≥0.05μm)を備えています。 )金ワイヤボンディングのニーズを満たすことができ、金の層を厚くすることで、金ワイヤボンディングプロセスの安定性と信頼性を確保できます。
1.2外観の効果
PCB処理ステップが多く、化学ニッケル-パラジウム-金プロセスの制御が複雑であるため、一部の国内PCBメーカーはプロセスについて不確実であり、PCBボンディングパッドの外観には、清浄度の低さなど、さまざまな欠陥があります。 、表面汚染、およびメッキの欠如。これらの欠陥は正しいです。SMT溶接プロセスは大げさに受け入れられますが、金線ボンディングプロセスは受け入れられません。典型的な欠陥タイプを図1に示します。PCBゴールドワイヤボンディングパッドの表面コーティングに欠陥があり、露出した銅または露出したニッケルに欠陥があり、金の層が摩耗しており、PCBパッドの穴の表面が風通しが良く、結合する方法がありません。合金ワイヤー。

図1 PCB表面のメッキの欠如はボンディングに影響します
1.3マイクロアセンブリプロセスの影響
マイクロアセンブリプロセスでは、化学ニッケル-パラジウム-金メッキPCBは、複数のリフローはんだ付け、クリーニング、および複数の導電性接着剤接合ステップをカバーする複雑なプロセスにさらされます。各ステップは、無電解ニッケル-パラジウム-金パッドの表面に汚染を引き起こし、金線の結合性に影響を与えます。SMTプロセスリフローはんだ付けでは、はんだペーストの微量フラックス残留物が無電解ニッケル-パラジウム-金パッドの接合性に大きな影響を与えます。はんだペーストの種類、洗浄形態、および洗浄プロセスパラメータを慎重に選択する必要があります。そして封じ込め。複数の溶接、特にキャビティ内の溶接と洗浄を防ぐために、組み立てプロセスの流れを可能な限り単純化する必要があります。
2.SMTはんだ接合の信頼性
理論的には、PCB化学ニッケル・パラジウムメッキ層は、ニッケルと金の間に薄いパラジウム層を参加させ、浸金プロセスにおける金のニッケル殲撃を遮断し、「ブラック溶接」現象を徹底的に回避する。実職の中で、プロセスは適切ではなくて、「黒溶接盤」現象も芽生えて、SMT溶接点の信頼性に影響して、制造品質の量に対して危害を招きます。
2.1 BGAインジケーター強度が低い問題現象(1)
某メーカーの某ロットの化学ニッケルとパラジウムをPCB基板にコーティングした植球后、制造過程で錫球のせん断力が異常に低いことが発覚した。タングステン針やステッチカッターで簡単にスズの球を落とすことができ、フラックオフの標準仕様のレガシーパッドを図2に示す。全体のバッチ基板はほぼ似たような問題がひらめいて、溶接盤位置を区別しません。切断インタフェースはNiと金属間化合物(IMC)の間にあり、ハンダとIMCの間にある。
同じ種類のHDI回路基板の他のバッチを選択し、同じプロセス条件に従ってボールを植え、同じ方法ではんだボールを押します。はんだボールは簡単に落下しません。ほとんどのはんだボールは表面配向の引張変形を持っています。 。落下後、はんだの大部分はボンディングパッドに残り、フラッシュオフの標準パターンおよび無電解ニッケル-パラジウム-金PCB基板BGAボール植栽せん断力のさまざまなバッチを表2に示します。
表2無電解ニッケル-パラジウム-金PCB基板のさまざまなバッチBGAボール植栽せん断力

GJB7677-2012ボールグリッドアレイ試験法のはんだボールせん断強度の推奨値によると、直径0.5mmのはんだボールの最小せん断力は3.5Nです。脆性破壊PCBのはんだボールせん断力はこの値よりも大きいが、せん断力の最終結果と比較すると、脆性破壊PCBの均一せん断力は約1.20 N低く、この強度差は高い場合に現れます。 -速度応力負荷条件。より表面的なものにする必要があります。
2.2微細構造の分析
製品のさまざまなバッチで断面分析を実行し、金属間化合物の形態を注意深く確認します。図3(a)はBGAボールの脆性破壊の顕微鏡写真であり、図3(b)はBGAボールの破壊の顕微鏡写真です。図3(a)の表面化は、ニッケル層が浸透して侵食されていることを示しています。
製品のさまざまなバッチの化学ニッケル-パラジウム-金パッドの表面は、特別なポーションで処理されています。図4(a)は、問題のPCB回路基板のパラジウム層の表面の写真です。パラジウムの表面層は銀白色で、グラフィックは不完全です。、腐食による浸透の残骸があります。図4(b)は、通常のPCB回路基板のパラジウム層の写真です。外観は銀白色で、グラフィックは完全で、平均は細かく正確であり、マイクロセクションの最終結果とまったく同じです。
2.3 BGAボールの植え付け強度が低い問題(2)
あるメーカーが製造しているマイクロ波混合板は無電解ニッケル-パラジウム-金メッキです。必要に応じてSMT +マイクロアセンブリプロセスを使用します。大型のBGA部品を表面に組み立て、SAC305はんだペーストを使用して組み立てます。 。リフローはんだ付けプロセスのパラメータは正常です。一般的な落下の試みでは、図5に示すように、製品のバッチにより、1〜2回の試行後にBGAコンポーネントグループがマザーボードから剥がれるという現象が明らかになりました。

図5BGAコンポーネントの溶接とストリッピングの素晴らしい部分
マザーボードからのBGAコンポーネントの取り外しが遅れており、パッドにはんだがほとんど残っていないことがわかります。これは、脆い切断であると結論付けることができます。
マイクロ波ハイブリッドボードのコーティングの低品位の違いを分析するために、同じコーティング厚さのPCB回路基板の異なるバッチを選択し、直径0.5mmのSAC305はんだボールを植えました。複数のリフローはんだ付けを実行して調査しました。コーティングを比較するためのせん断力の変化無電解ニッケル-ゴールドコーティングの値の増加の影響、最終結果を表3に示します。
表3複数回のリフローはんだ付け後の化学ニッケル-パラジウム-金PCBボードBGAのせん断力

通常の基板上のパラジウムコーティングのエネルギースペクトル分析(表4を参照)は、パラジウムおよびニッケル元素に加えて、リンの含有量も少ないことを示しています(品質パーセンテージは5.23 100%です)。問題のある基板上のパラジウムコーティングのエネルギースペクトル分析は、パラジウムおよびニッケル元素に加えて、酸素含有量も高いことを示しています(品質パーセンテージは12.07 100%)。これは、の分析とまったく同じです。前の写真、問題のある基板パッドの表面が酸素化されていることを確認します。
表4金除去後の正常基板と問題基板のエネルギースペクトル分析の最終結果

このタイプの基板のパラジウム層は厚いですが、詳細で正確ではありません。ニッケル層と連絡するためにパラジウム層の表面に微細孔があります。「パッド」現象は、取り付け後にBGAコンポーネントの脆い切断を引き起こします。図6に示すように。
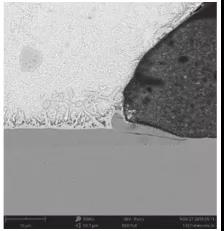
図6はんだボールとはんだマスク間の接続面が表面化されていますニッケル腐食チャネルを詳しく見てみましょう
問題NiPdAu基板の界面IMCは、はんだ付け後の通常の基板形状とはかなり異なります。問題は、NiPdAu基板の界面IMCが針状、通常のNiPdAu基板の界面IMCが島型、界面IMCであるということです。ニッケル-金基板のフラッシュアイランド型のようなものです。針状の金属間化合物の応力は比較的大きく、図7に示すように、リフロー溶接の数が増えると、サイズの拡大によりせん断がわずかに急速に減少します。問題のある基板を切断した後、パッドはNi層として残され、外部切断インターフェースはIMCとNi層であり、これは脆い切断であり、受け入れることができません。通常の基板せん断では、IMCまたはIMCとはんだボール金属の混合インターフェースが残り、切断されたインターフェースはIMCとはんだボール金属の間にあります。これはプラスチックの切断です。

図73回のリフローはんだ付け後に破損した障害のある基板のマイクロセクション
2.4エンドバイサイド分析とHDI回路基板処理方法
壊れやすい切断されたPCB基板の化学物質であるニッケル-パラジウム-金の外観の色は正常で、清潔で汚染がなく、金のワイヤボンディングの評判は正常です。めっき層の厚さの一般的な値は、ニッケルの場合は3.0〜5.0μm、パラジウムの場合は0.1〜0.2μm、金とパラジウムの場合は0.1〜0.2μmです。
NiPdAu基板とSAC305はんだのリフローはんだ付けプロセス中に、基板の表面の金とパラジウムがはんだ中のスズとすばやく反応して(AuPdNi)Sn 4合金を形成し、はんだに完全に引き伸ばされます。微細で正確な(Cu、Ni)6 Sn 5金属間化合物を形成し、金属間化合物とニッケル層の間の界面にNi 3Pの薄層が形成されます。Ni 3 Pは(Cu、Ni)6 Sn 5の層で覆われているため、Ni(P)の表面でのNi消費量が少なく、はんだ接合の信頼性が保証されます。
ニッケルの腐食とパラジウム層の欠陥の場合、製造プロセス中のパラジウム浴の負荷が低いことが、パラジウムの沈泥不良の主な原因です。シロップの活性を維持するために、パラジウムタンクの負荷の管理基準を確立する必要があります(0.3〜0.7 dm 2 / Lなど)。金の化学的浸漬中、副作用により、金がパラジウム層の欠落部分に浸透してニッケルを破壊し、ニッケルが腐食して黒いパッドの現象を引き起こします。いくつかの黒いパッドが存在するため、はんだ接合の強度が大幅に低下します。ニッケルめっき層ははんだ付け性が悪いためにはんだと十分な金属間化合物を形成できず、パッドとはんだボールの間に十分な金属間化合物が形成されず、最終的にはんだ接合強度が不十分なため部品がPCBから剥がれます。
3.結論
PCB無電解ニッケル-パラジウム-金コーティングは、表面実装、導電性接着剤接合、金/アルミニウムワイヤボンディングプロセスなど、マイクロアセンブリプロセスに関連するすべてのプロセス要件を同時に満たすことができます。コストが低く、メッキ層は理論的にはニッケル腐食の問題を防ぎますが、実際の製造では、不適切なメッキプロセスのために、ニッケル腐食の欠陥やパラジウム層の欠陥も発生します。このプロセスは、マルチチップモジュール(MCM)などのマイクロアセンブリプロセスでますます使用されています。生産品質を確保するためには、PCB加工や工場検査の品質管理を強化する必要があります。具体的な処理方法は次のとおりです。
1)PCBメーカーは、化学ニッケル-パラジウム-金シロップとプロセスパラメータを厳密に監視して、プロセス品質がしっかりしていて安定していることを確認する必要があります。各コーティングの厚さパラメータに加えて、パラジウム層の品質は平均的で正確でなければなりません。 、酸素化なしで、外観は滑らかで、細心の注意を払っており、正確です。色は金色です。
2)検査のために工場に入るときは、金のワイヤボンドの張力、はんだボールのせん断力、および切断フォームを監視します。必要な場合は、金属組織のセクションを取り、ニッケルの腐食がないかどうかを注意深く確認します。