半導体業界が究極の集積化と性能最適化を追求する波の中で、システムレベルパッケージ(System in Package、SiP)技術はその独特な集積優勢によって、伝統的なパッケージのボトルネックを突破する鍵となる方案です。センサ、メモリチップ、論理チップなどの多種類の素子を単一パッケージ体内に統合することにより、SiPはシステムレベルの機能を実現しただけでなく、DFN(Dual Flat No-lead)などの先進的なパッケージ技術との結合を通じて、電子製品の設計パラダイムを再定義しします。
一、SiPパッケージ技術の核心優勢と技術アーキテクチャ
SiP技術の核心は、ハイブリッド集積技術を通じて、単一パッケージ内で多型素子の協同作業を実現することにあります。その技術アーキテクチャは平面スタックの2D構造と垂直スタックの3D構造を支持し、前者はワイヤボンディング技術を通じてチップ相互接続を実現し、後者はフリップチップ溶接、シリコンスルーホール(TSV)などの技術を用いて信号伝送路を短縮します。
システムレベルのチップ(SoC)に比べて、SiPの優位性は顕著です。
開発サイクルの短縮:複雑なレイアウト配線を行う必要がなく、設計検証時間が減少し、局所変更コストがより低い。
異種集積能力:異なるプロセスノード(例えばCMOS、SiGe、GaAs)のチップと互換性があり、アナログ/RF、デジタル回路のハイブリッドパッケージをサポートする。
性能最適化:チップレイアウトと相互接続を最適化することにより、信号遅延が減少し、ノイズ干渉が減少し、システム帯域幅が向上する。
コスト効果:成熟したチップ資源を利用して、SoCの高い流体チップコストを回避し、特に消費電子などの高速反復分野に適している。
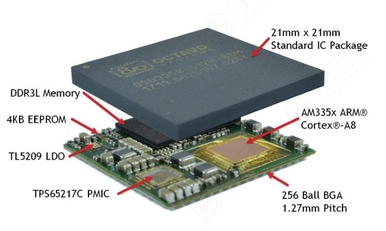
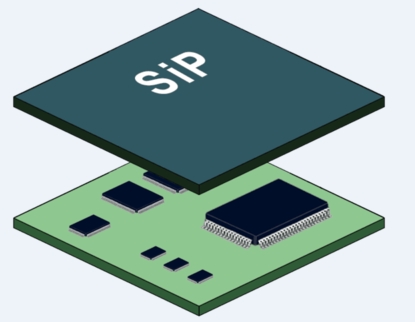
図 SIPパッケージ
二、SiPパッケージとDFNパッケージの協同革新
DFNパッケージはピンレスで平坦化されたパッケージ形式として、その特性はSiP技術と高度に一致しています。
構造上の利点:DFNパッケージはパッドアレイ設計を採用し、伝統的なピンがなく、パッケージの体積を著しく減少させ、同時に電気性能と放熱効率を向上させる。
プロセス融合:SiPプロセスは高精度位置決め、精密相互接続(例えばマイクロバンプ、TSV)などの技術を通じて、マルチチップと受動素子をDFNパッケージ体内に集積し、機能密度と信頼性の二重向上を実現する。
電源絶縁チップを例に、SiPプロセスを採用したDFNパッケージ方式は従来のSIPパッケージより75%縮小し、性能の向上が顕著である:
集積度突破:電力制御、周波数電力放電などの機能モジュールを単一DFNパッケージに集積し、PCB占有面積を減少する。
信号完全性の最適化:チップ間相互接続長を短縮することにより、RC遅延を低減し、高速データ伝送をサポートする。
熱管理の改善:DFNパッケージの扁平構造はSiPの放熱設計と結合し、高出力シーンでの安定性を向上させる。
三、SiPパッケージの技術進化と応用シーン
3Dパッケージ、Chiplet技術の融合に伴い、SiPパッケージはより高い集積度とより低い消費電力の方向に向かって発展しています。
3Dスタック技術:TSVを通じてチップ垂直相互接続、例えば8チップスタックSiPを実現し、機能密度を著しく向上させる。
Chiplet多重:複雑なシステムを標準化チップ粒子(Chiplet)に分割し、SiPパッケージを通じてモジュール化組み合わせを実現し、設計の複雑さを低減する。
アプリケーションシーンが上書きされている。
無線通信:5 G基地局、無線周波数フロントエンドモジュール、SiPを通じてPA、フィルタ、スイッチなどの素子を集積し、高周波、低消費電力の需要を満たす。
医療電子:携帯機器中のマルチセンサ融合、SiPパッケージは生物信号収集と処理の一体化を実現する。
自動車電子:ドメインコントローラ、パワーモジュール、SiPの耐高温、耐振特性を利用してシステム信頼性を向上させる。
四、SiPパッケージとDFNパッケージの技術比較と将来傾向
従来のパッケージ技術(SOP、QFNなど)に比べて、SiP+DFN方式は集積度、電気性能、コストの間でより優れたバランスを実現します。
将来的には、AIoT、ウェアラブルデバイスなどの市場の爆発に伴い、SiP技術はさらに先進的なパッケージ材料(例えば低誘電率媒体)、異種集積技術(例えば光電共パッケージ)と結合し、電子製品の「より小さく、より速く、よりスマート」への進化を推進します。
SiPパッケージ技術は従来のパッケージの限界を打破することにより、システムレベルの思考でチップ集積方式を再構築し、DFNパッケージは物理的に実現された高効率なキャリアを提供します。両者の結合は帯域幅、消費電力、集積度などの核心的な課題を解決しただけでなく、半導体業界にムーアの法則を超える新しい道を切り開きます。技術融合の深化に伴い、SiP+DFN方案はスマート端末、自動運転などの分野でより大きな価値を放出し、将来の電子システム設計の核心インフラとなります。