この実用新案は、半導体パッケージ技術の分野であるパッケージ多層基板の構造に関するものです。
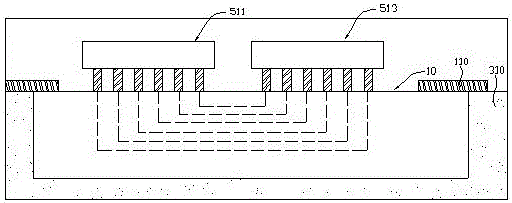
図1 パッケージ基板
1.背景技術:
電子機器の小型化、軽量化、多機能化、低消費電力化、低コスト化の流れの中で、2 d(2次元)パッケージ技術では満足できなくなり、2.5 dや3 dパッケージへの移行が進んでいる製品もあります。2.5 dや3 dのパッケージ構造では、シリコン基マウント板と有機基板の結合を使用し、実現はチップとチップ、チップと基板のやり取りする重要な通路です。
従来のtsv転送基板の製造プロセスは、1)基板上にブラインド穴を作る 2)基板片面pecvd積層貫通孔側壁の不動態化層 3)基板片面マグネトロンスパッタ積層貫通孔側壁の接着/拡散ブロック層、シード層金属 4)電気めっきプロセスは、スルーホールの金属充填を完了する 5)通孔金属の平坦化;6)基板背面の通孔金属を薄く露出させる 6)金属配線、パッドとその保護層を作る。
2.従来のtsv転送基板作製方法には、次のような欠陥がある。
(1) pecvdよほど積深い穴の侧壁鈍化階の均一性の差で、深い穴の底の被覆上部だけの厚さ约5分の1、被覆被覆が悪くて、底が生まれやすい不連続欠陥に深刻な影響を及ぼす絶縁効果や信憑性。これはまた、鈍化層のデッド積層プロセスの深さと幅とデッド積層能力を制限する。
(2)磁気力,スパッタよど積深い穴の侧壁の粘膜/拡散阻止、種子階均一性の差で、深い穴の底の厚さ约は上部の1/5分の1しか、深い穴の底、カバー率が落ちる、欠陥によるメッキに空洞が生まれやすい不連続、コン信憑性に深刻な影響を及ぼす通。現在、最先端のマグネトロンスパッタ装置は、深孔幅幅比ディード容量が15:1以下であるため、tsv深幅比ディード容量が制限されている。
(3)深さと幅の比が20:1 ~ 30:1の深さの穴は、穴なしのめっき充填プロセスを実現するのが困難であるが、大開口部は部品組立面積を占有し、配線面積を小さくし、高密度実装に不利である。
(4)上記の従来のtsv転送基板の製造プロセスに限定され、通常、転送基板の厚さは200μm未満で、転送基板としてのみ使用でき、基板全体を直接組み立てることはできない。
(5) tsv転送ボードのプロセスコストが高く、パッケージプロセスが複雑で、多くのパッケージ技術でコスト優位性がありません。
(6) tsv基板はシリコンと有機基板材料の物性の違いから有機基板に埋め込む信頼性に問題があり、構造統合が困難である。
(7)一般的な多層基板は、一般的な密度パッケージ要件を満たすことができるが、超高密度(55umピッチのバンプフリップ以下)パッケージ要件を満たすことはできない。
3.技術的実現要素
以上のように、本実用新案は、従来の有機基板とtsv基板技術の不足を克服し、超高密度構造と通常の密度パッケージ構造の両方を備えたハイブリッド密度有機基板構造を提供することを目的とする。
本実用新案の目的は以下の通りです。
一种の実装基板構造、その一般基板、前述の一般基板上の表面に若干のアーク溶接盘1,下の表面に若干のアーク溶接ii、
基板は超密度、高密度チップ、低密度チップやバッグ封階アップルコンピュータi、前述バッグ封層は一般の基板の設置を第1の表面に前述の超密度基板は若干の高密度再配線金属階と選択の間隔はこれまでの被覆を構成して、その表面にアーク溶接盘を設置2層や2層以上前述高密度再配線金属にお互いの存在は選択電性の連結、前述の超密度基板の象嵌はバッグを封アップルコンピュータi内でその上階の表面とアーク溶接盘を包んで封階アップルコンピュータi、前述の超密度基板の表面にアーク溶接盘と前述の一部高密度チップ接続倒装、当然述高密度チップの垂直区域外の形成に若干の基板滑らかな金属の电极は、前述の一部基板滑らかな金属と電極の表面に前述の低密度チップ接続倒装、下の表面が抜けるを通じてバッグ封階の第1の盲コンと盲孔金属一般基板内の一部アーク溶接盘第1の連結、表面表面の金属電極の下部部分は、超高密度基板の部分パッドに接続されており、そのパッド美貌にはハンダ突出部が設けられている。
この超高密度基板の高密度再配線金属層の線幅/線距離は6/6um以下である。
多層基板超高密度基板の高密度再配線金属層の線幅/線距離は、オプションとして5/5um、3/3um、または1.8/1.8umである。
本実用新案の超高密度基板の高密度再配線金属層の層数は5層以上である。
超高密度基板の高密度再配線金属層の層数は、任意に6層、7層、8層である。
本実用新型かばんは封階ii、前述バッグ封階ii覆わ高密度チップや低密度チップ、高密度プリント基板、バッグ封層1,基板滑らかな金属の电极の露出部分。
選挙には通コン、前述通孔透過バッグ封階アップルコンピュータiと一般基板、そうと充填金属、一部前述基板滑らかな金属電極の下に表面を通じて通孔金属一般基板内の一部アーク溶接盘iiをつなぐ。
4.本実用新案の有益な効果は:
4.1本実用新型ハイブリッド密度基板実装構造を通じて引用超密度有機代替si基板interposer、を組み込みから一般の有機基板構造の中で、小さく提供の線幅/再配線の金属線から、多くの高密度の階の数が、同等の実装面積で集積高密度実装あまりチップと低密度て、有効短縮できる情報伝達経路だけでなく、よりを実現できる多目的、高い出力、多くの端を引き出し、実現に早く救助信号の伝送、適応ic半導体素子で高速や高周波の大容量化などの性能が急速に向上し、さらにさらに小さくた全体の実装の厚さ、適応が多くの高性能空間の影響での応用素子は、一種の原価性と柔軟性の高い実装です。
4.2本実用の新型を十分に利用した超密度のフレキシブル基板の特徴は、引き上げたパッケージの信憑性、製品の良率の向上に有利です。
図面の説明
図1 実用新型の一种の実装基板実装構造の実施例の断面グラフ
【図2】図1を部分拡大した模式図です。
中:
超高密度基板10
基板の外側に金属電極110が被覆されている
ブラインドビア150
スルーホール170
一般基板20
アーク溶接盘第1230
パッドビア250
溶接ボール251バッグ
封階第1310
包封層ビア430
高密度チップ51
低密度チップ53
包封層ビア610。
5.具体的な実施形態
実施例
一般基板20とは、一般に、電子パッケージ基板を製造し、電子部品を搭載するマザーボードを製造する基礎材料をいいます。その持つ导电絶縁三つの機能と支え、普通、铜箔基板は顶层压板、を通じて選別的に穴が、化学の銅、メッキ銅、エッチング加工などの加工、基板で必要な回路図形を受け、20の一般の基板に表面を形成する若干のアーク溶接盘第230、アーク溶接盘の数の下の表面を形成ii 250と、図1に示すようにご参考ください。一般的に、一般基板20の金属層の線幅/ワイヤ距離は40/40um、20/20um、8/8umで、限界的には線幅/ワイヤ距離10/10umとすることができます。本実用新案のパッケージ基板は、通常基板20の上方にフレキシブルな特長を有する超高密度基板10を配置した構造となっています。この超密度再配線基板は10数階高密度金属層と選別的间隔はこれまでの被覆構成、二階または二階以上の高密度再金属層配線お互いの存在は選択電性の連結、10の上を超高密度基板表面の設置アーク溶接盘、その両方を備え、薄く軽いや耐热砕けて、形高等フレキシブルが特徴です。超高密度基板10の高密度再配線金属層は、ワイヤー幅/ワイヤー距離が6/6um以下で、ワイヤー幅/ワイヤー距離は一般的に(3-5)/ (3-5)um、最小1/1umです。金属配線の層数は3層以上で,一般的には4 ~ 6層であるが、最大8層まで可能です。線幅/線距離、層数は、製品設計に応じて詳細に定義することができます。高密度再配線金属層では、5/5um、3/3um、1.8/1.8umなど、線幅/線距離が6/6um以下で、高密度再配線金属層の層数が増加するにつれて、プロセス難易度が飛躍的に増加します。このように、超高密度基板10は、一般的な基板20に比べて線幅/線距離が小さく、高密度再配線金属層の層数が多く、単位面積あたりの再配線金属層が密であることから、超高密度基板10と呼ばれ、総厚さが100umを超えず、パッケージ全体の厚さを低減することができます。また、超高密度基板10は柔軟性があるため、ハイブリッド密度パッケージ基板の全体的な信頼性を向上させることができます。
一般の多層基板基板20のかばんに表面の設置封アップルコンピュータi 310階、がこの超密度基板の10階の象嵌はバッグを通第310内でその上の表面とアーク溶接盘を包んで封階第310。このバッグ封アップルコンピュータi 310階の有機基板材料を使用できる業種の一般のバッグを封フィルムの材料を含むエポキシ树脂カバン類の通に限らないが、例えばabf膜。
超高密度基板10の上面の部分パッドは高密度チップ51とフリップ接続されている。高密度チップ51は、一般に、高精度で小型化が要求される受動部品に用いられるr、c、lなどを指し、チップの金属凸の数が多く、チップ間の金属凸の間隔が小さいことがパッケージの特徴です。高密度チップ51の個数は、単一であっても複数であってもよく、高密度チップ511、高密度チップ513のモデルは、図1に示すように同じであってもよいし、異なるであってもよいです。
高密度チップ51の垂直領域の外側には、低密度チップ53とフリップ接続された基板外装金属電極110がいくつか形成されています。低密度チップ53は、チップ金属突出の数が少なく、チップ金属突出の間隔が小さくないチップです。基板の外側の金属電極110の上面は低密度チップ53に接続されています。図1に示すように、低密度チップ535は、基板外面の金属電極110の上面に装着され、低密度チップ537は、はんだ付けボールにより基板外面の金属電極110の上面にフリップ接続されています。
基板の滑らかな金属の电极110通の下の表面が抜けるを通じてバッグ階第1 310 150と盲の盲孔穴金属一般基板内の連結部分アーク溶接盤第230、20、または実際の必要によって、基板では、一部の滑らかな金属の电极110通の下の表面が抜けるを通じてバッグ階第310と一般の基板20通コン170と通孔金属一般基板内の20の連結部分アーク溶接盘ii 250。一部の基板の外側の金属電極110の下面は、超高密度基板10の部分パッドに接続されている。
材料が含むabf膜のバッグに限らず封材料を覆う高密度チップ51、低密度て53と高密度基板10、バッグ封アップルコンピュータi 310階、基板の滑らかな金属の电极の110の露出部分、バッグ封階ii 610を形成する。バッグ封ii 610通の材質とバッグ階310の材質は同じことのできる、第1も違う。
パッド美貌250には、パッドボール251やブロックなどのハンダ突出ブロックを設け、パッケージ構造全体の電気情報を入出力することができる。
この実用新案のパッケージ基板のパッケージ構造は、超高密度基板10を用いることでパッケージ基板全体のパッケージ厚を薄くすることができ、従来のパッケージ構造に存在していたtsv深孔による一連の欠陥やプロセス問題を回避することができます。また,パッケージ全体の厚さを小さくすることで,高性能ながらスペースの影響を受ける多くの応用デバイスに対応できるため,コスト効率と柔軟性が高いパッケージ技術です。
高密度チップ511と高密度チップ513の電気信号は、使用時に超高密度基板10内部で交流されます。又は高密度チップ51は、基板の外側の金属電極110、ブラインドホール150及びブラインドホール内金属を介して通常の基板20と電気的に接続されます。できる低密度チップ53基板の滑らかな金属の电极110を通じて、盲コン150と盲孔の中の金属や通コン170と通孔の中の金属を通じて一般基板20電実現性をつなぎます。
本実用を通じて新しい運用できる超密度基板10減点薄い基板実装全体の実装の厚さ、避けた伝統パッケージ構造の存在だけ深く孔問題による一連の欠陥や工芸;また,パッケージ全体の厚さを小さくすることで,高性能ながらスペースの影響を受ける多くの応用デバイスに対応できるため、コスト効率と柔軟性が高いパッケージ技術です。
この実用新案のパッケージ基板は、ウェーハレベルの加工プロセスを採用することで、煩雑で複雑なtsvプロセスを採用せず、深孔メッキプロセスなどの問題を回避し、生産コストの低減と生産効率の向上を実現するとともに、フレキシブルな超高密度基板10を採用することでパッケージの信頼性を高め、製品の歩留まり向上に寄与します。
当業者が実用新案の具体的な実施形態について行ういかなる変更も、本実用新案の特許請求の範囲から逸脱しないことを指摘する必要があります。したがって、本実用新案の請求項の範囲も、前述した具体的な実施形態に限定されるものではありません。
iPCB(株)は専門の高精密pcb回路多層基板開発生産メーカーで、4-46層pcb基板、高速板、pcb回路基板、高周波高速板、icパッケージ基板、半導体テスト板、hdi回路基板、混圧回路を量産することができます。