pcb エッチングプロセス(Etching Process)は化学的または物理的方法により材料表面の特定領域を選択的に除去するマイクロ加工技術であり、半導体製造におけるパターン転移のキーポイントである。
その核心的な目的は、レジスト上の2次元パターンを基板材料に正確に移し、3次元微細構造を形成することである。
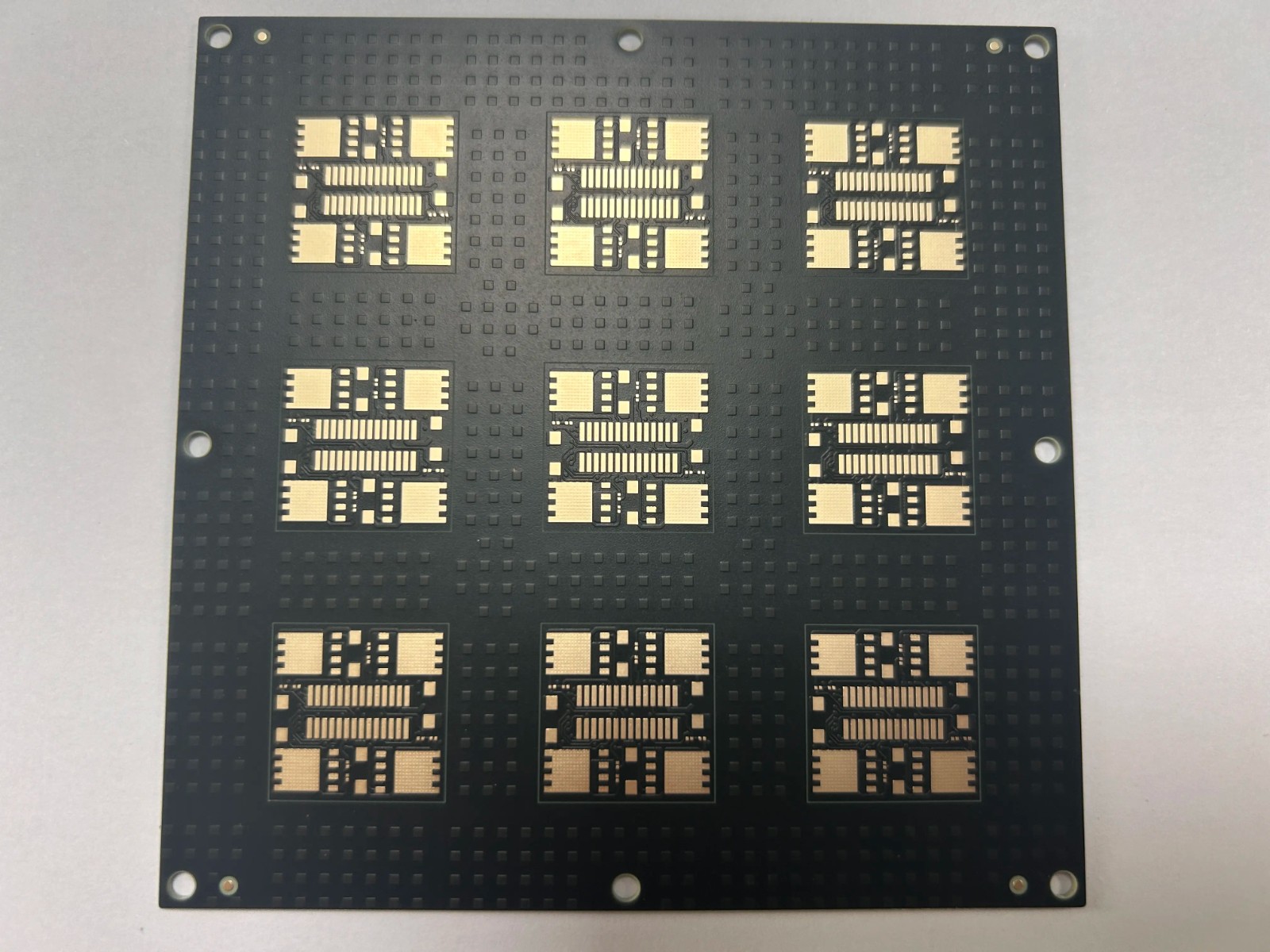
半導体製造プロセスでは、エッチングプロセスはフォトリソグラフィ、堆積とともに3つの基本プロセスモジュールと呼ばれている。現代の集積回路の製造には、通常40〜60回のエッチング工程を経る必要があり、その精度はトランジスタの性能とチップの良率を直接決定する。7 nmプロセスノードを例にとると、エッチング精度は±1 nmレベルに達する必要がある。
pcb エッチングプロセスの基本原理は、レジストに保護されていない材料領域を選択的に除去することにより、パターン複製を実現することである。作用機序によって次のように分けることができます。
化学エッチング:化学反応による材料の溶解
物理エッチング:イオン衝撃による材料のはく離
物理化学複合エッチング:両者の優位性を結合する
一.ウェットエッチング技術の詳細
ウェットpcb エッチング(Wet Etching)は、液状化学試薬と材料との酸化還元反応を利用して選択的除去を実現する伝統的なプロセスである。その典型的な反応過程は3つのステップに分けることができる:
1.材料表面への反応物の拡散
2.表面化学反応による可溶性生成物の生成
3.生成物が表面から離れて溶液に入る
ウェットエッチングの典型的な技術的特徴:
等方性:横エッチング速度は縦方向と同等
選択比:最大100:1以上
プロセスウィンドウ幅:パラメータ変動に敏感ではない
一括処理:複数枚のウエハを同時に加工可能
二.ドライエッチング技術の詳細
ドライpcb エッチング(Dry Etching)はプラズマから発生した活性粒子を利用して材料除去を実現し、主に以下の技術タイプを含む:
1.反応性イオンエッチング(RIE):
無線周波電源によるプラズマ発生
イオン垂直衝撃増強異方性
典型的な圧力:10-100 mTorr
2.誘導結合プラズマエッチング(ICP):
イオン密度とエネルギーを独立に制御する
高深度アスペクト比構造を実現可能
エッチング速度は1μm/min以上
ドライエッチングの重要なプロセスパラメータ:
無線周波数電力:イオンエネルギーに影響する(通常100〜1000 W)
ガス流量:エッチング化学平衡を決定する(10-100 sccm)
チャンバ圧力:粒子の平均自由行程(1-100 mTorr)に影響する
バイアス電圧:制御イオン衝撃エネルギー(50-500 V)
三.シーン解析の適用
ウェットエッチングの一般的な用途:
シリコンウェハ洗浄と表面前処理
MEMSデバイスバルクシリコン加工
太陽電池のテクスチャリング
パッケージ基板貫通孔の作製
表示パネルITOパターン化
ドライエッチングの典型的な用途:
ロジックチップゲートエッチング
3D NANDメモリ深穴エッチング
FinFETフィン成形
先進パッケージTSVスルーホール
化合物半導体装置のメサ分離
これが異なるpcb エッチング技術です。